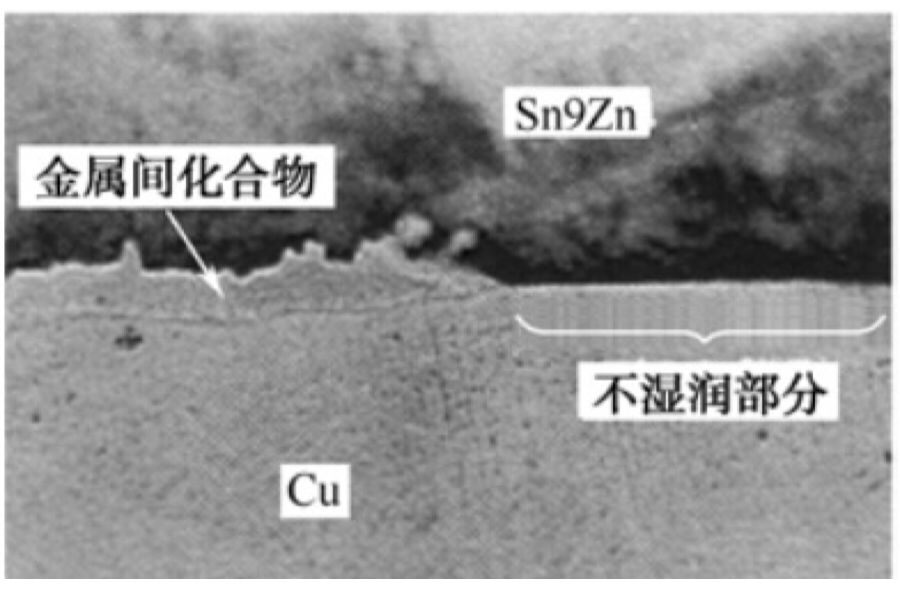 图5
图5
焊料在电极上润湿而形成化合物,这一冶金现象,可以将其作为界面层形成的指标。由此可知,所期望的在界面上所形成的金属间化合物,应该是厚度均匀且无缺口的状态。钎料在电极上润湿时,在界面上可能存在异物卷入或存在气泡的痕迹。后者受存在的氧化膜的影响很大,这些气泡存在于焊料圆角内部或界面上,可能将导致焊接强度的弱化。
因此,对焊接场地的控制要求是,焊接场地空间尘埃要少,要避免异物的混入,要防止PCB基板的污染和氧化,同时要加强对焊料的管理。焊接温度过高或者在峰值温度下滞留的时间过长,这在促进界面反应,加速金属间化合物层生成的同时,也是形成空隙的条件。这种在焊接过程中由于元素原子扩散沿方向上的差异所导致的空隙,称为柯肯多尔效应。这是在焊接过程中所发生的现象。
由于孔隙是洞穴,不言而喻将使界面的强度降低。为此,加强对焊接温度曲线的管理是非常重要的。另一个使人困扰的现象是电极侧在焊接前因劣化导致的黑色焊盘现象。这是由于在电镀过程中所发生的腐蚀现象而隐藏于基板上的。由于该现象在焊接时看起来是正常的,但在生产和市场服役中却屡次引起故障。显然,它是导致焊接时界面反应形成黑色焊盘的一个原因。焊接结束后熔融焊料凝固时,体积要缩小,在焊接安装基板时,使焊料凝固过程照原样状态进行。保持焊料凝固的组织状态自然是很重要的。
特别是无铅波峰焊接场合,产生的焊盘剥离、凝固裂纹或形成硬而脆的金属间化合物等特殊现象。焊盘剥离的典型状态如图6所示。这些凝固缺陷的形成及其影响因素的管理项目主要有:焊料合金元素、镀层元素、焊料成分的管理(特别是波峰焊接钎料槽中的钎料成分的管理),元器件和基板设计形状,冷却条件等。

图6
三、应用中焊点可靠性的蜕变现象
作为焊接后的PCBA等制品,装入机柜内便可以进入实际的工作状态,通常均称为焊接制品。由于产品使用条件千差万别,因此,电气、电子机器种类也是成千上万。为此必须确保每一种产品的可靠性,这应成为每一个产品设计和制造工艺的基准。首先,要把影响产品寿命及影响温度周期等指标作为通用的指标。对此,各产品之间的差异如表2所示。表2

电子装备在应用中产生的缺陷而可能导致装备失效的问题的描述如图7所示。
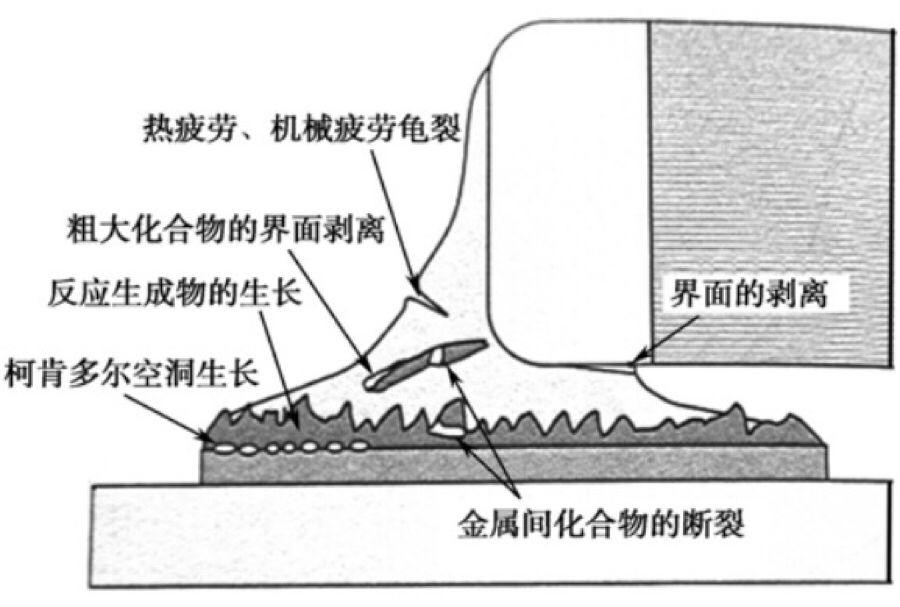
图7
在市场服役中发生的故障,大多数都具有复合因素综合作用的结果。据统计,凡涉及BGA、CSP芯片的故障,几乎有90%是发生在焊接部分,分析其影响因素几乎都具有复合性。再如,由高温储存所导致的产品劣化现象,这是由于接续界面金属间化合物层在持续地生长,导致其生长得过厚所带来的后果。另外,由于人们在操作中反复开关机器时所施加于机器等的周期性应力造成的机械疲劳、振动等也是导致失效的原因。









